SMT贴片BGA焊接不良的诊断与处理
一、BGA焊接不良包含哪些不良现象?
1)锡膏桥接(短路)
锡膏桥接指的是相邻的焊点焊接出现连接,一般会造成短路。
2)空洞
空洞指的是BGA焊接后,焊球内部出现空洞或者气泡,这会影响BGA的正常工作
3)冷焊
冷焊指的是焊球表面无光泽,未完全熔化
4)拉尖
拉尖指BGA底部焊球高低不平,焊球呈现短尺或拉长的形态
5)焊点偏移
焊点偏移指的是焊球与pcb焊盘出现位置偏差
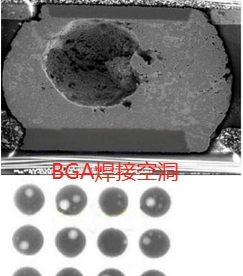
二、BGA焊接不良的判定方法
无损检测方法
1)X射线检测
X射线检测是利用X-RAY检测设备,通过X射线的穿透力,对BGA底部焊球进行检测,可以检测BGA焊点释放短路,桥接,空洞,断裂,浮高等等不良问题
破坏性检测方法
1)电路板切片检查
通过切片检查锡球的剖面,观察BGA底部焊球的焊接情况
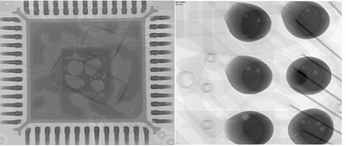
目前大部分的BGA焊接不良检测判定方法,基本都是利用X-ray检测设备进行,一方面效率高,另外一方面检测更加精准
三、BGA焊接不良的原因有哪些
1)BGA焊接需要精准的温度曲线,预热不足或峰值温度过高可能导致焊球熔化不均,出现虚焊或焊球桥接
2)锡膏印刷量不足、偏移或厚度不均会影响BGA焊球的润湿性,导致焊接强度不足
3)PCB或BGA受热不均可能发生翘曲,导致部分焊球无法良好接触焊盘
4)焊球或焊盘氧化、PCB表面污染(如助焊剂残留)都会影响焊接可靠性
5)冷却过快可能导致焊点脆化,冷却过慢则可能使焊点晶粒粗大
四、BGA焊接不良的改善方法
1)调整温度曲线,确保在焊接过程中的温度控制,避免受热不均或不足
2)提升贴片精度,确保BGA底部球点与pcb焊点精准
3)锡膏印刷确保平整度、不偏移焊盘、厚度均匀且同时选用品质好的锡膏
4)确保锡膏与pcb焊盘的润湿性

151-1810-5624
尹先生
